工艺逼近3nm,极限厚度仅0.7nm!中国团队再次突破“芯片卡脖子”的关键材料!

当全球芯片竞赛的硝烟弥漫到1纳米关卡,一则来自中国的科研消息,在半导体业界投下了一颗“深水炸弹”。
2026年4月,来自国防科技大学与中国科学院金属研究所的联合团队,在国际顶级期刊《国家科学评论》上公布了一项震撼性成果。
他们成功实现了新型二维半导体材料“氮化钨硅”的晶圆级制备与可控掺杂。这条消息背后的技术突破,直指芯片产业的未来核心。
芯片制程的微缩,堪称一场“在头发丝上刻摩天大楼”的极限挑战。传统的硅基芯片,发展到5纳米、3纳米时,已经能听到物理规律发出的“摩擦声”。电子行为越来越难以控制,发热和能耗问题日益严峻。
国际半导体技术路线图早已预测,传统的硅技术将在2030年左右撞上性能的天花板。摩尔定律的延续,急需找到一条全新的路径。
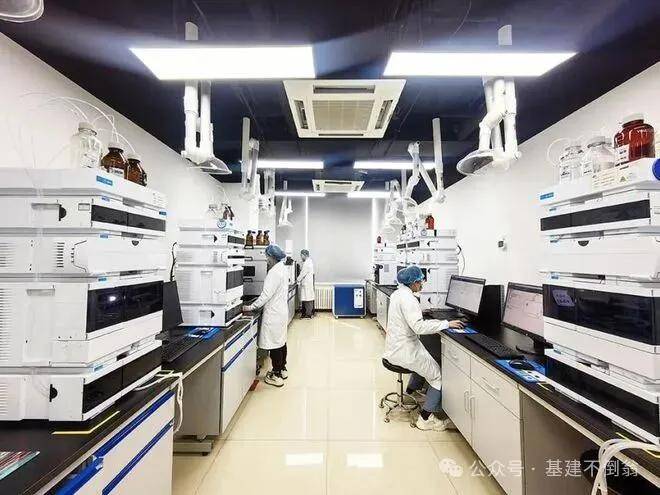
二维半导体,就这样闯入了研究者的视野。这类材料天生就是原子级别的薄片,本身具备优异的半导体特性。
其厚度可以轻松做到1纳米以下,相当于把未来“等效1纳米”级别的芯片结构,从图纸上“预制”了出来。
性能更强、能耗更低,是它最诱人的名片。但要把这种潜力从实验室的显微镜下,搬到工厂的流水线上,中间横亘着巨大的鸿沟。材料的生长、掺杂工艺,每一关都是拦路虎。
去年,北京大学刘开辉教授团队的成果让人眼前一亮。他们用铟和硒,开发出一种“固-液-固”的晶圆生长策略,迈出了关键一步。而这次,国防科大与金属所的团队,直接把“油门”踩到底。
他们采用的是一种基于液态金与钨双金属薄膜的化学气相沉积新工艺。这波操作带来的最直接效果,就是将晶圆生长的速度,提升了近一千倍。从“精雕细琢”到“批量下料”,量产可能性的大门被撬开了一条坚实的缝隙。

更值得关注的是,这项研究从一开始就瞄准了工程化应用。团队已经在上海建成了一条工程验证示范线,目标直指今年完成8英寸晶圆的工艺优化,并启动2纳米乃至1纳米器件的流片验证。
这意味着,它不只是《科学》杂志上一篇精美的论文,而是从实验室走向生产线的“先遣队”。
那么,中国科研力量为何在二维半导体领域如此执着,频频实现“多点开花”?这背后是一盘关于技术自主的大棋。
传统的硅基芯片产业链,从设计软件、制造设备到材料工艺,壁垒极高,且被少数巨头把持。二维半导体被视为一种“换道”的可能。
它从材料底层出发,有望绕开部分传统技术路线上难以逾越的专利墙和设备封锁,构建起一套新的技术体系。
当然,这绝非易事,意味着从材料、设备到设计规则的全面重构,是一条漫长而艰难的道路。
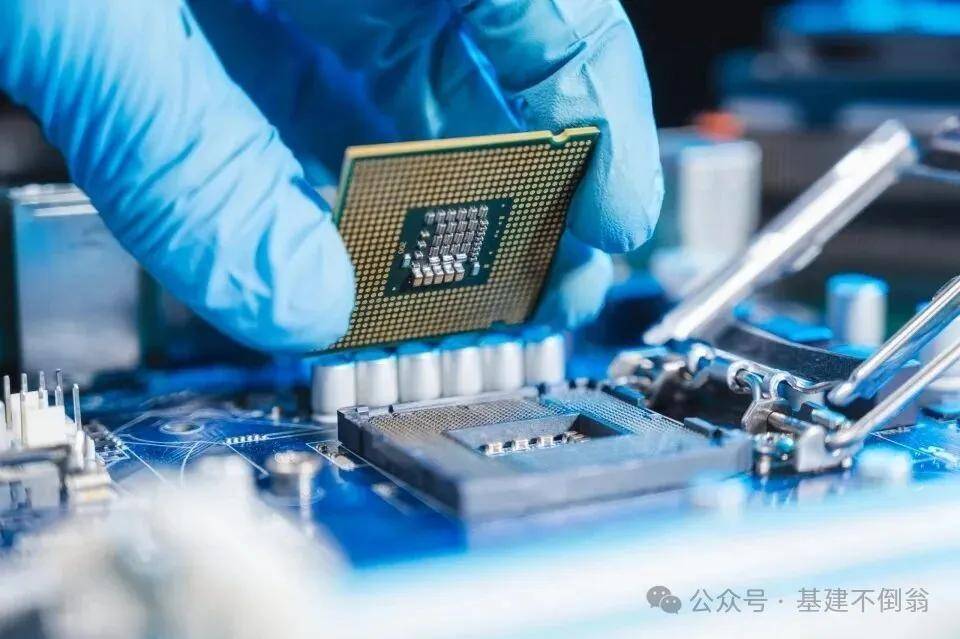
但无论如何,每一次在基础材料和核心工艺上的突破,都是在为未来的技术自主增加一块基石。
当别人在高墙内迭代工艺,选择在新材料的荒野上另辟蹊径,需要的不仅是智慧和汗水,更是长远的战略眼光与持续的投入。
这次关于氮化钨硅的突破,无疑是这条长征路上的又一个坚实脚印。芯片的未来战争,或许才刚刚在另一个维度打响。






























